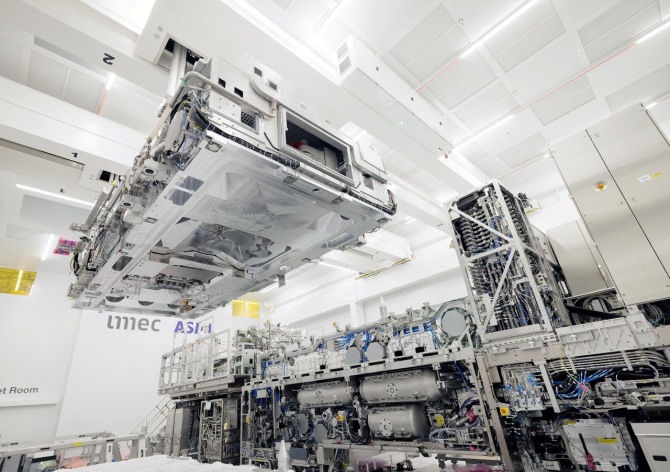 이미지 확대보기
이미지 확대보기EUV 노광장비 개발은 난이도가 높아 예상보다 훨씬 더딘 상황이다. 현재 반도체 업계는 13.5나노(nm) 파장 EUV 기술 이후의 미래를 가늠하기 어려워하고 있다. EUV 노광장비 시장을 독점하는 ASML은 개구수를 늘려 장비 성능 개선에 집중하고 있으며, 업계는 2030년경 개구수가 최소 0.75까지 증가할 것으로 전망한다.
현재 8nm 해상도와 단일 노출로 최대 16nm 하프 피치를 생성하는 하이NA 장비는 곧 한계에 부딪힐 것으로 보인다고 외신은 전했다. 벨기에 반도체 연구센터 아이멕(Imec)은 2030년경 7nm 공정 도입 시 이러한 한계에 직면할 것으로 예상한다.
마틴 반 덴 브링크 ASML 전 CTO는 2024년 2월 하이퍼 NA 계획을 발표하며 EUV 노광장비의 미래를 제시했다. 그는 아이멕 국제 기술 포럼에서 대략적인 개발 일정을 공개했지만, ASML은 타당성 조사 단계임을 강조하며 신중한 태도를 유지하고 있다. 한편, 자이스는 이미 하이퍼 NA용 렌즈 개발에 착수한 것으로 알려졌다.
하이퍼 NA, 새로운 과제 직면
하이퍼 NA 개발에는 몇 가지 과제가 남아있다. 하이NA는 초점 심도를 감소시켜 더 얇은 마스크를 요구한다. 이는 완전한 노출을 가능하게 하지만, 에칭 과정에서 마스크 영역 보호를 어렵게 만든다.
광학 분야에서도 편광 수차로 인한 콘트라스트 감소 문제가 발생한다. 편광 필터를 사용해 해결할 수 있지만, 광원 강도가 감소하므로 출력을 높여야 한다. 하이퍼 NA에는 더 큰 거울이 필요할 수도 있다.
로우NA에서 하이NA로 전환하면 1차 미러 직경이 거의 두 배(65cm에서 120cm)로 커진다. 이는 노광 장비뿐 아니라 테스트 장비 크기도 키운다. 자이스는 하이NA 미러용으로 직경 5m의 진공 챔버를 제작했다.
로우NA 및 하이NA 장비 개선 기대
하이퍼 NA용 광원 개선은 로우NA 및 하이NA 장비에도 도움이 될 것으로 보인다. 노출 선량 증가는 시간당 웨이퍼 생산량 증대를 의미한다. 차세대 로우NA 장비인 NXE:4000F는 2026년부터 약 250Wph 생산이 가능하며, 현재 NXE:3800E는 220Wph를 목표로 한다.
장기 목표는 로우NA의 경우 400Wph 이상, 하이NA의 경우 약 300Wph다. 이는 노출 선량을 현재 30mJ/cm2에서 50mJ/cm2로 크게 늘려 달성할 수 있다. ASML은 장기적으로 다양한 EUV 장비 시리즈를 표준화하고, 대부분 동일한 구성 요소를 사용하며 광학은 별도의 완전 통합 어셈블리로 구성할 계획이다. ASML은 이미 NXE 시리즈의 하이NA 시스템으로 이러한 단계를 밟았다. 이 시스템은 최초의 로우NA 장비보다 훨씬 모듈식으로 설계되었으며, 해당 구성 요소를 부분적으로 활용하고 있다.
노정용 글로벌이코노믹 기자 noja@g-enews.com