2025년부터 2031년까지 진행되는 사업에 선제적 기술 지원
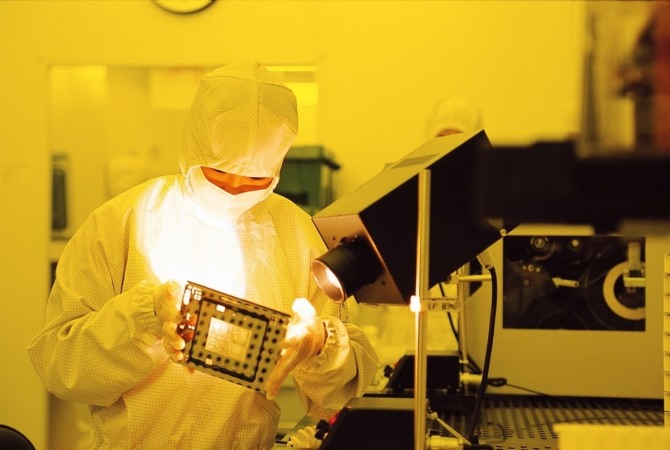 이미지 확대보기
이미지 확대보기산업통상자원부는 국가연구개발사업평가 총괄위원회에서 '반도체 첨단 패키징 선도 기술 개발 사업'이 총사업비 2744억원 규모로 예비타당성 조사를 통과했다고 26일 밝혔다.
첨단 패키징은 반도체의 성능·전력·내구성을 높이기 위해 신기술과 재료 등을 적용하는 것을 말한다. 생성형 인공지능(AI) 바람을 타고 그래픽처리장치(GPU), 고대역폭메모리(HBM) 등 고성능 반도체 수요가 급증하는 가운데 반도체 업계에서는 미세 공정의 기술적 한계를 극복하기 위해 로직 칩, 메모리 등 개별 반도체를 묶어 성능을 최적화하는 패키징 기술의 중요성이 커지고 있다.
산업부는 2025년부터 2031년까지 진행할 사업을 통해 칩렛, 3D 패키징 등 향후 5~10년 사이에 시장 적용이 확대될 가능성이 큰 차세대 패키징 핵심 기술의 선제적 기술 개발을 지원하기로 했다. 아울러 2.5D, Fan-In·Fan-Out 등 글로벌 종합 반도체 기업이 양산 중인 고부가 모듈 구현에 필요한 소재·부품·장비 공급망 내재화를 위한 자립형 기술 개발도 지원한다.
산업부는 "디지털 전환에 따른 고성능·다기능 반도체 수요 증가에 따라 미세 공정의 기술적 한계 극복을 위한 핵심 기술로 첨단 패키징이 부상하고 있다"며 "첨단 패키징 초격차 기술 확보 및 기업의 세계 시장 진출을 촉진하고 국내 반도체 공급망 안정성을 강화하는 데 기여할 것으로 기대한다"고 밝혔다.
김정희 글로벌이코노믹 기자 jh1320@g-enews.com